
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
چپ مینوفیکچرنگ میں SiGe: ایک پروفیشنل نیوز رپورٹ
سیمی کنڈکٹر مواد کا ارتقاء
جدید سیمی کنڈکٹر ٹکنالوجی کے دائرے میں، مائنیچرائزیشن کی طرف مسلسل مہم نے روایتی سلیکون پر مبنی مواد کی حدود کو دھکیل دیا ہے۔ اعلی کارکردگی اور کم بجلی کی کھپت کے تقاضوں کو پورا کرنے کے لیے، SiGe (Silicon Germanium) اپنی منفرد جسمانی اور برقی خصوصیات کی وجہ سے سیمی کنڈکٹر چپ مینوفیکچرنگ میں انتخاب کے ایک جامع مواد کے طور پر ابھرا ہے۔ یہ مضمون میں delvesepitaxy عملSiGe کا اور اپیٹیکسیل گروتھ میں اس کا کردار، تناؤ والے سلکان ایپلی کیشنز، اور گیٹ آل اراؤنڈ (GAA) ڈھانچے۔
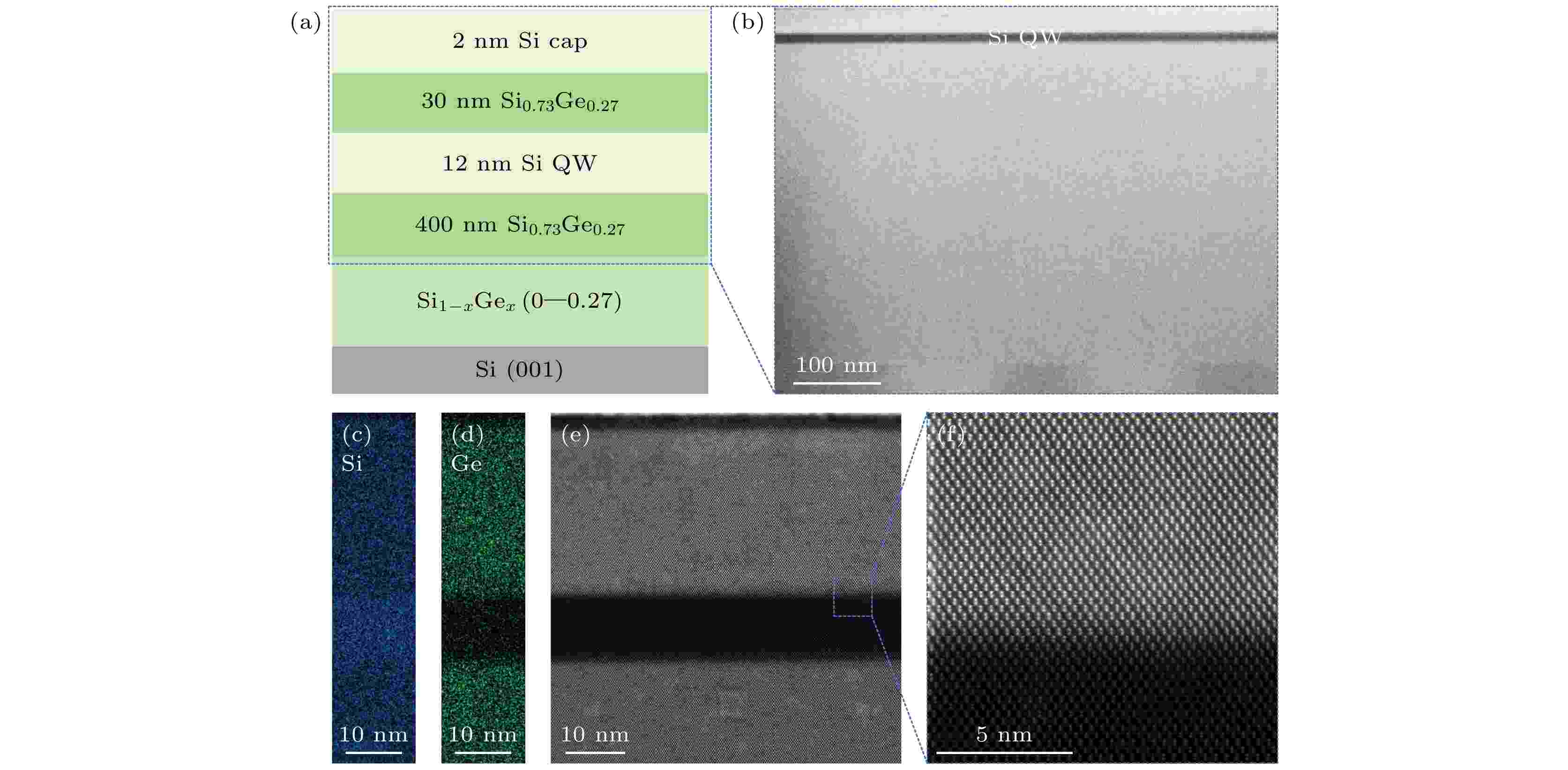
SiGe Epitaxy کی اہمیت
1.1 چپ مینوفیکچرنگ میں ایپیٹیکسی کا تعارف:
Epitaxy، جسے اکثر Epi کہا جاتا ہے، ایک ہی جالی کے انتظام کے ساتھ سنگل کرسٹل سبسٹریٹ پر سنگل کرسٹل پرت کی نمو کو کہتے ہیں۔ یہ تہہ یا تو ہو سکتی ہے۔ہوموپیٹاکسیل (جیسے Si/Si)یا heteroepitaxial (جیسے SiGe/Si یا SiC/Si)۔ اپیٹیکسیل گروتھ کے لیے مختلف طریقے استعمال کیے جاتے ہیں، جن میں مالیکیولر بیم ایپیٹیکسی (ایم بی ای)، الٹرا ہائی ویکیوم کیمیکل ویپر ڈیپوزیشن (UHV/CVD)، ایٹموسفیرک اور کم پریشر ایپیٹیکسی (ATM اور RP Epi) شامل ہیں۔ یہ مضمون سیمی کنڈکٹر انٹیگریٹڈ سرکٹ پروڈکشن میں سیمی کنڈکٹر انٹیگریٹڈ سرکٹ پروڈکشن میں بڑے پیمانے پر استعمال ہونے والے سلیکون (Si) اور سلکان-جرمینیم (SiGe) کے ایپیٹیکسی عمل پر توجہ مرکوز کرتا ہے جس کو سبسٹریٹ مواد کے طور پر استعمال کیا جاتا ہے۔
1.2 SiGe Epitaxy کے فوائد:
کے دوران جرمینیم (Ge) کا ایک خاص تناسب شامل کرناepitaxy عملایک SiGe سنگل کرسٹل پرت بناتی ہے جو نہ صرف بینڈ گیپ کی چوڑائی کو کم کرتی ہے بلکہ ٹرانجسٹر کی کٹ آف فریکوئنسی (fT) کو بھی بڑھاتی ہے۔ یہ وائرلیس اور آپٹیکل مواصلات کے لئے اعلی تعدد والے آلات میں بڑے پیمانے پر لاگو ہوتا ہے۔ مزید برآں، اعلی درجے کے CMOS انٹیگریٹڈ سرکٹ کے عمل میں، Ge اور Si کے درمیان جالیوں کی مماثلت (تقریباً 4%) جالی کے تناؤ کو متعارف کراتی ہے، جس سے الیکٹران یا سوراخوں کی نقل و حرکت میں اضافہ ہوتا ہے اور اس طرح آلے کی سنترپتی کرنٹ اور ردعمل کی رفتار میں اضافہ ہوتا ہے۔
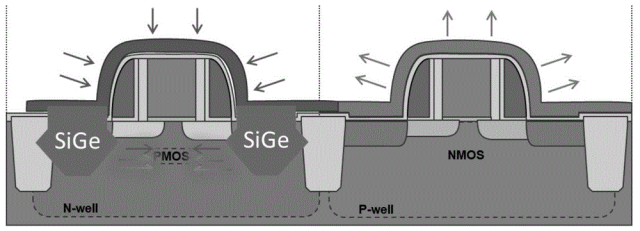
جامع SiGe ایپیٹیکسی عمل کا بہاؤ
2.1 قبل از علاج:
سلکان ویفرز کو مطلوبہ عمل کے نتائج کی بنیاد پر پہلے سے علاج کیا جاتا ہے، جس میں بنیادی طور پر قدرتی آکسائیڈ کی تہہ اور ویفر کی سطح پر موجود نجاست کو ہٹانا شامل ہے۔ بھاری ڈوپڈ سبسٹریٹ ویفرز کے لیے، اس بات پر غور کرنا بہت ضروری ہے کہ آیا بعد میں آٹو ڈوپنگ کو کم کرنے کے لیے بیک سیلنگ ضروری ہےepitaxy کی ترقی.
2.2 نمو کی گیسیں اور حالات:
سلیکون گیسیں: سائلین (SiH₄)، Dichlorosilane (DCS، SiH₂Cl₂)، اور Trichlorosilane (TCS، SiHCl₃) تین سب سے زیادہ استعمال ہونے والے سلکان گیس کے ذرائع ہیں۔ SiH₄ کم درجہ حرارت کے مکمل ایپیٹیکسی عمل کے لیے موزوں ہے، جبکہ TCS، جو اپنی تیز رفتار ترقی کی شرح کے لیے جانا جاتا ہے، موٹی کی تیاری کے لیے وسیع پیمانے پر استعمال ہوتا ہے۔سلکان ایپیٹیکسیتہوں
جرمینیئم گیس: جرمینیم (GeH₄) جرمینیم کو شامل کرنے کا بنیادی ذریعہ ہے، جو SiGe مرکب بنانے کے لیے سلیکون ذرائع کے ساتھ مل کر استعمال ہوتا ہے۔
سلیکٹیو epitaxy: سلیکٹیو گروتھ کی رشتہ دار شرحوں کو ایڈجسٹ کرکے حاصل کی جاتی ہے۔epitaxial جمعاور سیٹو اینچنگ میں، کلورین پر مشتمل سلکان گیس DCS کا استعمال کرتے ہوئے سلیکٹیوٹی سیلیکون کی سطح پر سی ایل ایٹموں کے جذب ہونے کی وجہ سے ہے جو آکسائڈز یا نائٹرائڈز سے کم ہوتی ہے، جس سے اپیٹیکسیل ترقی میں سہولت ہوتی ہے۔ SiH₄، Cl ایٹموں کی کمی اور کم ایکٹیویشن انرجی کے ساتھ، عام طور پر صرف کم درجہ حرارت کے مکمل ایپیٹیکسی عمل پر لاگو ہوتا ہے۔ ایک اور عام طور پر استعمال ہونے والا سلیکون ذریعہ، TCS، بخارات کا کم دباؤ رکھتا ہے اور کمرے کے درجہ حرارت پر مائع ہوتا ہے، اسے رد عمل کے چیمبر میں داخل کرنے کے لیے H₂ بلبلے کی ضرورت ہوتی ہے۔ تاہم، یہ نسبتاً سستا ہے اور اکثر اس کی تیز رفتار شرح نمو (5 μm/منٹ تک) کے لیے استعمال کیا جاتا ہے تاکہ موٹی سیلیکون ایپیٹیکسی تہوں کو اگایا جا سکے، جس کا وسیع پیمانے پر سلیکون ایپیٹیکسی ویفر کی پیداوار میں اطلاق ہوتا ہے۔
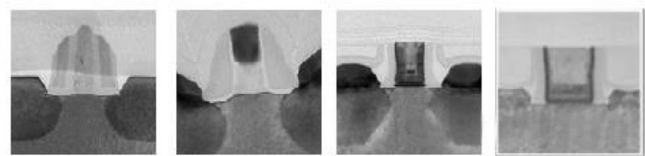
Epitaxial تہوں میں تنا ہوا سلکان
دورانepitaxial ترقی، ایپیٹیکسیل سنگل کرسٹل Si کو ایک آرام دہ SiGe پرت پر جمع کیا جاتا ہے۔ Si اور SiGe کے درمیان جعلی مماثلت کی وجہ سے، Si سنگل کرسٹل پرت بنیادی SiGe پرت سے تناؤ کا شکار ہے، جس سے NMOS ٹرانجسٹروں میں الیکٹران کی نقل و حرکت میں نمایاں اضافہ ہوتا ہے۔ یہ ٹیکنالوجی نہ صرف سیچوریشن کرنٹ (Idsat) کو بڑھاتی ہے بلکہ ڈیوائس کے ردعمل کی رفتار کو بھی بہتر کرتی ہے۔ PMOS ڈیوائسز کے لیے، SiGe تہوں کو اینچنگ کے بعد ماخذ اور نالی والے علاقوں میں epitaxily اگایا جاتا ہے تاکہ چینل پر کمپریسیو تناؤ متعارف کرایا جا سکے، سوراخ کی نقل و حرکت میں اضافہ ہو اور سنترپتی کرنٹ میں اضافہ ہو۔
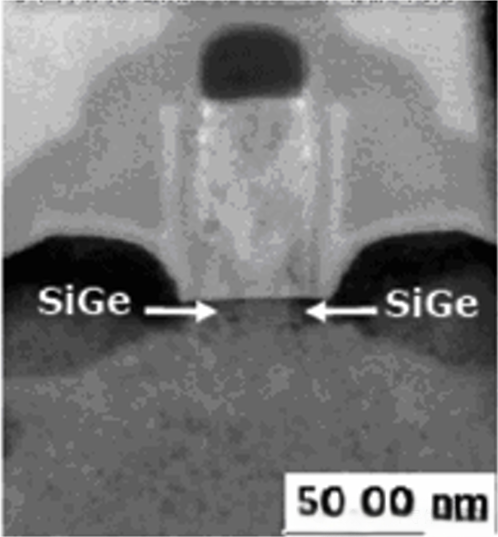
GAA ڈھانچے میں قربانی کی تہہ کے طور پر SiGe
گیٹ آل آراؤنڈ (جی اے اے) نانوائر ٹرانزسٹروں کی تیاری میں، سی جی پرتیں قربانی کی تہوں کے طور پر کام کرتی ہیں۔ ہائی سلیکٹیوٹی انیسوٹروپک اینچنگ تکنیک، جیسے کہ کواسی-ایٹمک لیئر اینچنگ (quasi-ALE)، نانوائر یا نانو شیٹ ڈھانچے بنانے کے لیے SiGe تہوں کو درست طریقے سے ہٹانے کی اجازت دیتی ہے۔
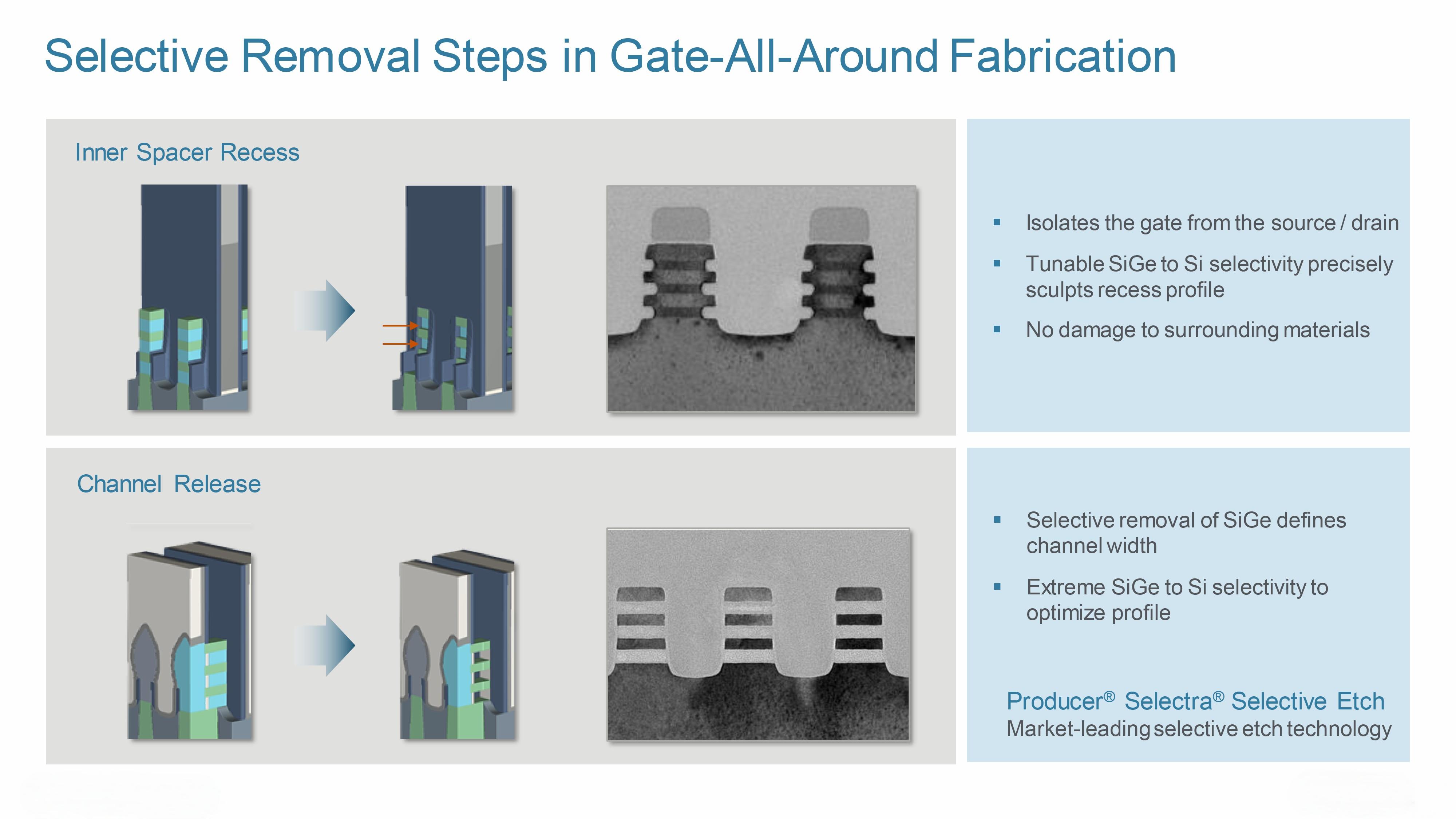
ہم Semicorex میں مہارت رکھتے ہیں۔SiC/TaC لیپت گریفائٹ حلسیمی کنڈکٹر مینوفیکچرنگ میں سی ایپیٹیکسیل گروتھ میں لاگو کیا گیا ہے، اگر آپ کو کوئی پوچھ گچھ ہے یا اضافی تفصیلات کی ضرورت ہے، تو براہ کرم ہم سے رابطہ کرنے میں ہچکچاہٹ محسوس نہ کریں۔
رابطہ فون: +86-13567891907
ای میل: sales@semicorex.com




